Low Temperature Sintering Equipment
Application
- Suitable for multi-scenario copper/silver sintering process
- It can be used for laboratory low-temperature copper diffusion connection research and industrial SiC power electronics module packaging
- Fine-Pitch bump bonding, solder/copper bump bonding
- Development and mass production of MEMS, optoelectronics and hybrid bonding
Technical advantage
- Relying on years of technical achievements from top laboratories at home and abroad
- Direct diffusion connection or low temperature solder paste sintering is possible
- Can be combined with nano-paste to provide a complete set of solution
- Safe, reliable and environmentally friendly
- Vacuum or a variety of controlled atmosphere oxidation protection
FATB series
-
Item Parameter Range of pressure 0~2000N/3000N/8000N (option) Stability of pressure ±10N Z axis stroke 90mm/120mm Temperature control range of pressure head RT~300℃ Pressure head temperature control stability ±1℃ Indenter heating rate (RT-250℃) 5min Upper sample size 0.5*0.5mm Lower sample size 50*50mm The catalytic box controls the temperature range and stability RT~250℃/±2℃ Catalytic box heating rate(RT-180℃) 5min Cooling Method Air -
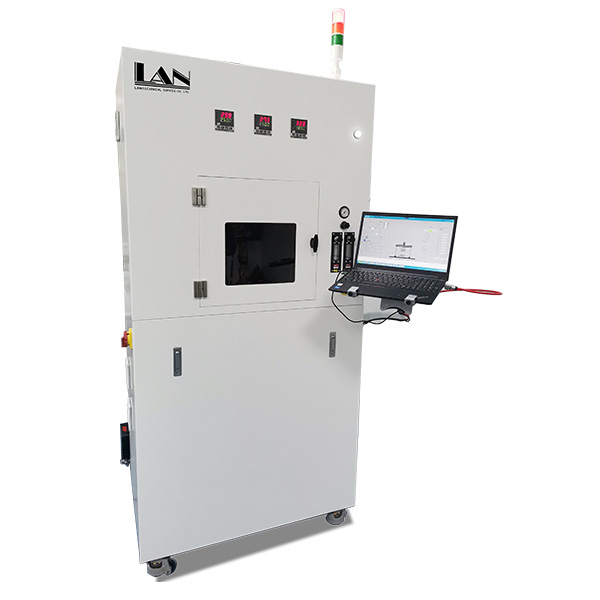
ASTB series Full auto
-
Item Parameter Maximum sintering pressure 30MPa Controlled pressure stability ±0.5MP Minimum spacing between chips 0.4mm Maximum effective sintering area 350mm*270mm Maximum sintering temperature 300℃ Uniformity of temperature ±3℃ Sintering temperature control stability ±1℃ Maximum clamping force 1000kN Maximum flow rate of activation gas 50L/min Preheating temperature RT~150℃ Preheating temperature stability ±1℃ Cooling Temperature Less than50℃ Oxygen content Less than50ppm Activation method Catalytic activation by formic acid -